
掃碼加微信

熱門關鍵詞:展至科技 氧化鋁陶瓷基板/支架 氮化鋁陶瓷基板/支架 陶瓷覆銅板 陶瓷電路板
電子封裝是一種將半導體集成電路上絕緣材料打包的技術,在芯片上是至關重要。所以看來電子封裝的選材堪憂重要,而且在電子封裝上用的基板材料要求都是低成本、易加工、高導熱性與絕緣等特性。
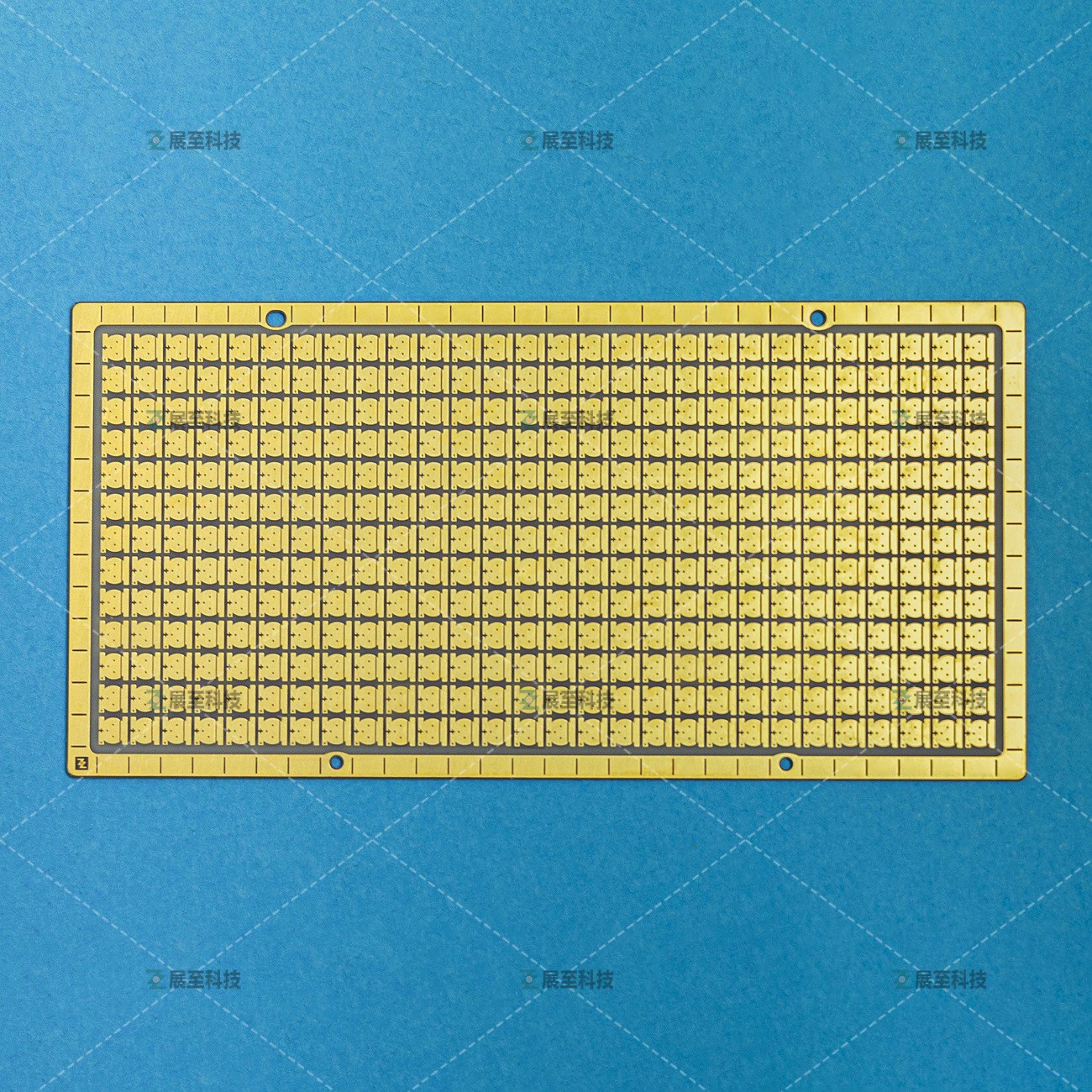
一、dpc陶瓷基板直接電鍍銅工藝過程
dpc又稱為直接鍍銅陶瓷基板因為其制作中將陶瓷基片進行前處理清洗,然后利用真空濺射方式在基片表面沉積Ti/Cu層作為種子層,接著以光刻、顯影、刻蝕工藝完成線路制作,最后再以電鍍/化學鍍方式增加線路厚度,待光刻膠去除后完成基板制作。
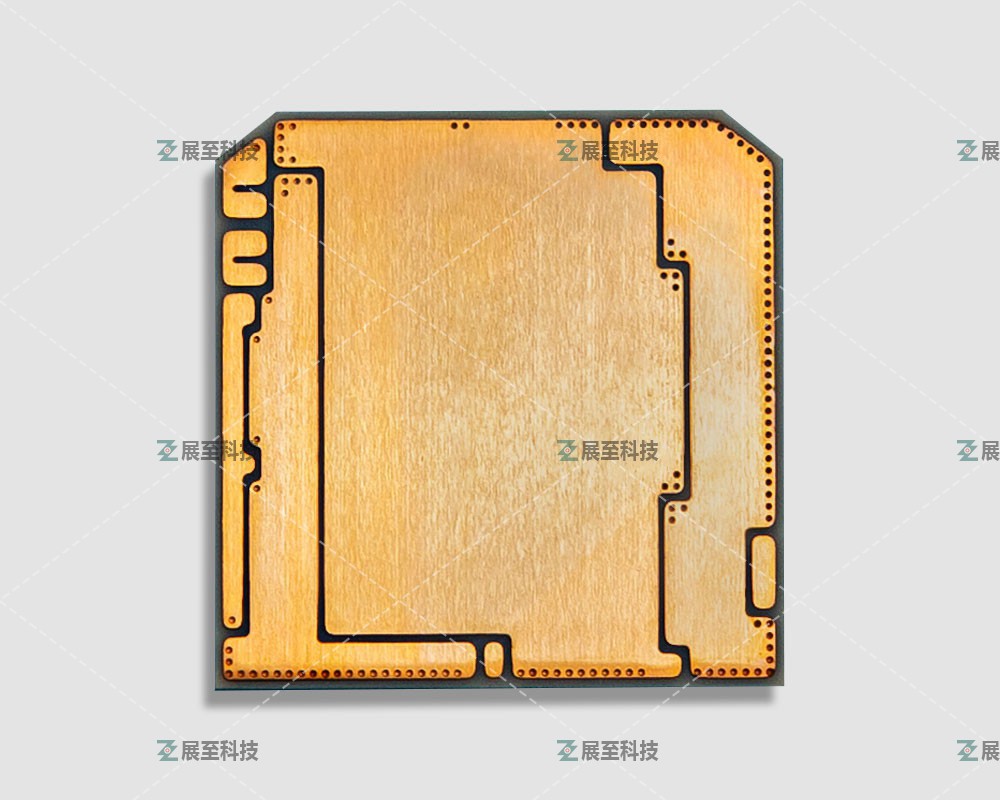
dpc陶瓷基板制備工藝,首先利用激光在陶瓷基片上制備通孔[孔徑一般為60~120μm],然后在利用超聲波清洗陶瓷基片。采用了磁控濺射技術在陶瓷基片的表面沉積金屬種子層[Ti/Cu],接著就是通過光刻、顯影完成線路層制作,最后采用電鍍填孔和增厚金屬線路層,并通過表面處理提高基板可焊性與抗氧化性,最后去干膜、刻蝕種子層完成基板制備。
二、dpc陶瓷基板優勢特點及關鍵技術
1.優勢
采用半導體微加工技術,陶瓷基板上金屬線路更加精細[線寬/線距可低至30-50μm,與線路層厚度相關]。
采用激光打孔與電鍍填孔技術,實現了陶瓷基板上/下表面垂直互聯,可實現電子器件三維封裝與集成,可降低器件體積。
采用電鍍生長控制線路層厚度[一般為10-100μm],并通過研磨降低線路層表面粗糙度。

2.關鍵技術
金屬線路層和陶瓷基片中的結合強度,因為金屬與陶瓷間熱膨脹系數差較大,為了降低界面應力,都是需要在銅層與陶瓷間增加過渡層,從而提高界面結合強度。并且由過渡層與陶瓷間的結合力主要以擴散附著及化學鍵為主,所以常選擇Ti、Cr及Ni等活性較高、擴散性好的金屬作為過渡層[也作為電鍍種子層]。
電鍍填孔也是dpc陶瓷基板制備的主要關鍵技術。在目前dpc基板中的電鍍填孔大多采用脈沖電源,因為其技術優勢要包括:易于填充通孔,降低孔內鍍層缺陷、表面鍍層結構致密、厚度均勻等,甚至可采用較高電流密度進行電鍍來提高沉積效率。
