
掃碼加微信

熱門關鍵詞:展至科技 氧化鋁陶瓷基板/支架 氮化鋁陶瓷基板/支架 陶瓷覆銅板 陶瓷電路板
隨著電子元器件不斷的持續發展,在精密電子以及航空航天等工業領域得到了進一步的推進,而這些領域都涵蓋了陶瓷基板的應用。其中,陶瓷基板因其優越的性能逐漸得到了越來越多的應用。
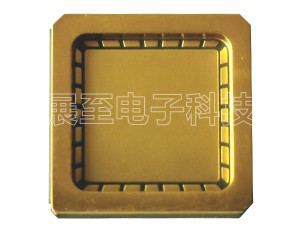
那么深紫外LED的光效主要是由外量子效率決定,而外量子效率受內量子效率和光提取效率影響。隨著深紫外LED內量子效率不斷提高(>80%),深紫外LED光提取效率成為限制深紫外LED光效提高的關鍵因素,而深紫外LED光提取效率受到封裝技術影響較為大。
深紫外LED封裝技術與目前的白光LED封裝技術有所不同。因為白光LED主要是采用有機材料例如環氧樹脂、硅膠進行封裝,但由于深紫外的光波長短且能量高,有機材料在長時間深紫外光輻射下會發生紫外降解,嚴重影響深紫外LED的光效和可靠性。所以,深紫外LED封裝環節對于材料的選擇尤其重要。

由于LED封裝材料主要包括出光材料、散熱基板材料和焊接鍵合材料,而其中出光材料用于芯片發光提取、光調節、機械保護等;散熱陶瓷基板用于芯片電互連、散熱與機械支撐等;焊接鍵合材料用于芯片固晶、透鏡鍵合等。
LED出光結構一般是采用透明材料實現光輸出和調節,同時對芯片和線路層起到保護作用。因此有機材料耐熱性差和熱導率低,深紫外LED芯片所產生的熱量會導致有機封裝層溫度升高,長時間高溫下有機材料出現熱降解和熱老化,甚至是不可逆的碳化現象。此外,在高能量紫外光輻射下,有機封裝層會出現透過率下降、微裂紋等不可逆的改變,并且隨著深紫外光能量不斷增加,這些問題更為嚴重,使得傳統有機材料難以滿足深紫外LED封裝需求。
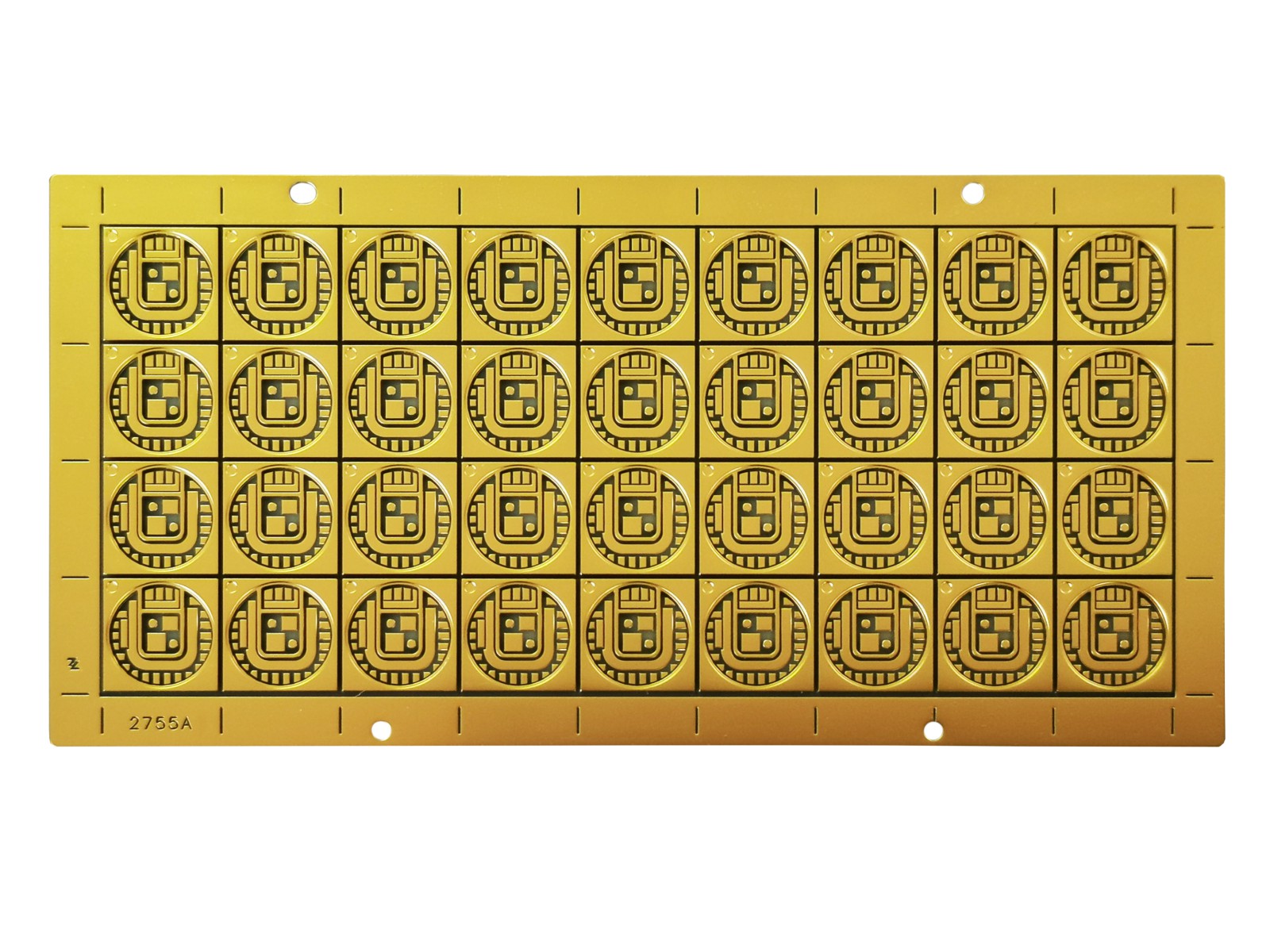
總體而言,有些部分的有機材料能夠耐受紫外光,但是由于有機材料耐熱性差和非氣密性,使得有機材料在深紫外LED封裝中仍然受到限制。因此,研發者也不斷嘗試采用石英玻璃、藍寶石等無機透明材料來封裝深紫外LED。
一、焊接鍵合材料:
深紫外LED焊接材料包括芯片固晶材料和基板焊接材料,分別用于實現芯片。玻璃蓋板(透鏡)與陶瓷基板間焊接。倒裝芯片常采用金錫共晶方式實現芯片固晶,水平和垂直芯片可利用導電銀膠、無鉛焊膏等完成芯片固晶。相對于銀膠和無鉛焊膏,金錫共晶鍵合強度高、界面質量好,并且鍵合層熱導率高,降低了LED熱阻。
玻璃蓋板焊接是在完成芯片固晶后進行,因此焊接溫度受到芯片固晶層耐受溫度限制,主要包括直接鍵合和焊料鍵合。直接鍵合不需要中間鍵合材料,利用高溫高壓方法直接完成玻璃蓋板與陶瓷基板間焊接,鍵合界面平整、強度高,但對設備和工藝控制要求高;焊接鍵合是采用低溫錫基焊料作為中間層,在加熱加壓條件下,利用焊料層與金屬層間原子相互擴散來完成鍵合,工藝溫度低、操作簡單。目前常采用焊料鍵合來實現玻璃蓋板與陶瓷基板間可靠鍵合,但需要同時在玻璃蓋板和陶瓷基板表面制備金屬層,以滿足金屬焊接需求,并且鍵合工藝過程中需要考慮焊料的選擇、焊料涂覆、焊料溢出和焊接溫度等問題。

二、散熱基板材料:
LED散熱陶瓷基板材料主要有樹脂類、金屬類和陶瓷類。其中樹脂類和金屬類基板均含有有機樹脂絕緣層,這會降低散熱基板的熱導率,影響基板散熱性能,而陶瓷類基板主要包括高溫/低溫/共燒陶瓷基板( HTCC /LTCC) 、厚膜陶瓷基板( TPC) 、覆銅陶瓷基板( DBC) 以及電鍍陶瓷基板( DPC)。
陶瓷基板具有機械強度高、絕緣性好、導熱性高、耐熱性好、熱膨脹系數小等諸多優勢,并且廣泛應用于功率器件封裝,特別是大功率LED封裝。由于深紫外LED光效較低,輸入的絕大部分電能轉換為熱量,為了避免過多熱量對芯片造成高溫損傷,需要將芯片產生的熱量及時耗散到周圍環境中,而深紫外LED主要依靠散熱陶瓷基板作為熱傳導路徑,因此高導熱陶瓷基板是深紫外LED封裝用的散熱基板的最好選擇。
