
掃碼加微信

熱門關(guān)鍵詞:展至科技 氧化鋁陶瓷基板/支架 氮化鋁陶瓷基板/支架 陶瓷覆銅板 陶瓷電路板
金剛石可是自然界里的熱導(dǎo)小霸王!它的熱導(dǎo)率簡(jiǎn)直牛翻啦,是其他材料望塵莫及的。單晶金剛石的熱導(dǎo)率在2200到2600 W/(m.K)之間,這數(shù)據(jù)讓人目瞪口呆。金剛石的膨脹系數(shù)也相當(dāng)可觀,大約是1.1×10-6/℃。它不僅在半導(dǎo)體、光學(xué)方面表現(xiàn)搶眼,還有很多其他優(yōu)秀的特性。雖然金剛石本身并不適合用來制作封裝材料,而且成本也較高,但它的熱導(dǎo)率可是比其他陶瓷基板材料高出幾十甚至上百倍!這也讓很多大公司都爭(zhēng)先恐后地投入研究。
根據(jù)相關(guān)資料,這款AMB金剛石覆銅板產(chǎn)品通過金剛石與具有良好機(jī)械性能的銅的復(fù)合,實(shí)現(xiàn)了高導(dǎo)熱,綜合熱導(dǎo)率范圍為500~1800W/(m·K),熱膨脹系數(shù)可調(diào)(3~6×10-6/K)。該產(chǎn)品還具有高強(qiáng)度、絕緣性好、體積電阻率(20℃)≥5×1013Ω·cm的特點(diǎn)。此外,其可鍍性好,表面易于鍍鎳、金,且熱膨脹系數(shù)與導(dǎo)熱率具有可設(shè)計(jì)性。

第三代半導(dǎo)體(如GaN和SiC)的發(fā)展推動(dòng)了功率器件不斷向大功率、小型化、集成化和多功能方向前進(jìn)。隨著集成度的提高和體積的縮小,單位體積內(nèi)的功耗不斷增加,導(dǎo)致熱量增加和溫度急劇上升。因此,散熱已成為阻礙大功率電子器件發(fā)展的瓶頸問題。
在大功率元件和系統(tǒng)的散熱基板方面,需要與之配套的熱管理材料具備導(dǎo)熱性能、與半導(dǎo)體芯片材料(Si或GaAs)相匹配的熱膨脹系數(shù)、足夠的剛度和強(qiáng)度,以及更低的成本。
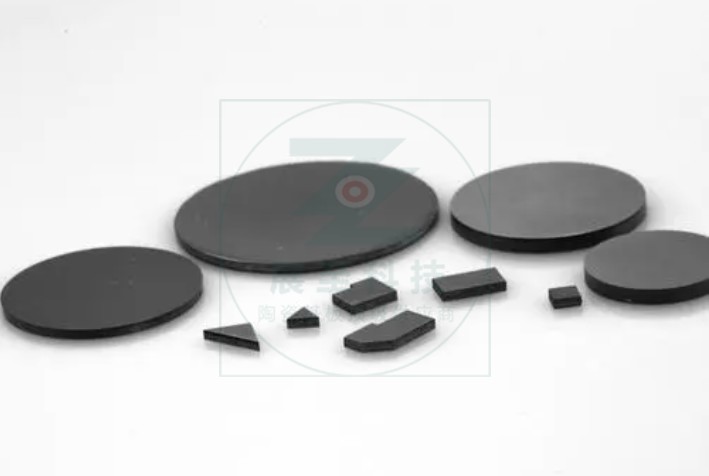
早在六十年代,就已經(jīng)開始嘗試使用金剛石作為散熱材料。金剛石是一種具有極高導(dǎo)熱性能和硬度的材料,常被用于高功率密度、高頻率電子器件的散熱。金剛石用作熱沉材料主要有兩種形式,即金剛石薄膜和將金剛石與銅、鋁等金屬復(fù)合。
金剛石與銅都具有高的熱導(dǎo)率(銅的熱導(dǎo)率為397W/(m·K)),且晶格常數(shù)相近,但二者也存在一些問題,例如熱膨脹系數(shù)相差很大,結(jié)合力不好(銅與碳相互不浸潤,銅不熔于金剛石)等。在制作過程中,通過借助中間層(如Ti-Pt-Au、Ti、Mo及Ta等)解決了結(jié)合力問題。

制作金剛石封裝基板的工藝流程如下:先將金剛石表面清洗干凈后烘干,再在其表面先用磁控濺射鍍膜一層金屬鈦,再鍍膜一層金屬銅,以保證金剛石基板與金屬的結(jié)合力。然后,經(jīng)過線路曝光、顯影、電鍍、蝕刻等步驟,形成電路圖形。在此過程中,還需要克服加工過程中金剛石高硬度的負(fù)面影響,以確保保障金剛石封裝基板的性能。
【文章來源】:展至科技
關(guān)鍵詞: 金剛石封裝基板 陶瓷基板廠家 IGBT模塊 DBC陶瓷基板 氧化鋁陶瓷基板 氮化鋁陶瓷基板 金剛石基板封裝
